- ホーム
- 電子顕微鏡関連
- TEM標準試料/キャリブレーション
- 当ページ
Ge/SiNキャリブレーション for EDX/XEDS (SEM, STEM and AEM)
Geは、厚さ20nmの窒化シリコンメンブレン上にパターニングされた2ミクロンのポアを横切って懸架されています。70°の傾斜で、薄い100ミクロン厚シリコンフレームは、任意の回転方向からウィンドウの中心内で約50x50ミクロンの領域を使用できるので、500 x 500ミクロンの単一ウィンドウは高い傾斜角トモグラフィーと互換性があります。
均一な、蒸着されたゲルマニウム(Ge)/窒化シリコン(SiN);
•検出器エネルギー軸とエネルギー分解能較正
•検出器ウィンドウの伝送評価
•検出器の立体角測定
•電子光学機器システムのピーク測定
•検体ホルダ半影測定
Geは一般にTEMカラムでは検出されないため、校正サンプルは機器のコンポーネントとその信号ピークと誤認することのない材料を提供します。システムのピークが通常発生する領域[2〜9keVおよび11〜20keV]にはGeのピークがありません。

Ge / SiNx膜のアモルファス構造を確認する領域回折パターンの選択
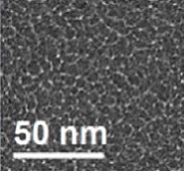
Ge / SiN膜のアモルファス構造を確認する領域回折パターンの選択Geアイランドは、
より高い倍率で目に見えるアイランド間のギャップが<1nm
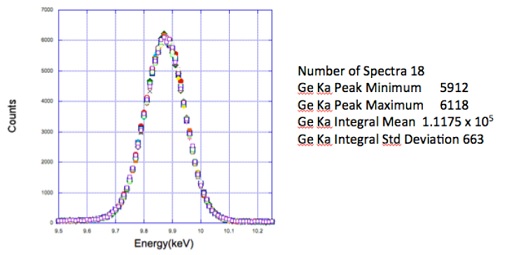
Ge / SiNウィンドウの2つの垂直方向にわたるスペクトルプロファイルの再現性
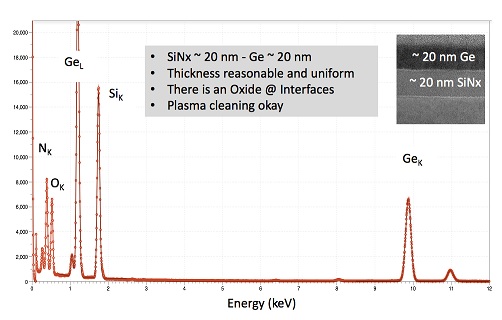
約1nAおよび200kVでの典型的なGe / SiNスペクトルプロファイル
• Zaluzec NJ, DesOrmeaux JP, and Roussie J. A Ge/SiNx Standard for Evaluating the Performance of X-ray Detectors in the SEM, S/TEM and AEM. Microscopy and Microanalysis, 22(S3): 322-323.
• Zaluzec NJ, Wen J, Wang J, and Miller DJ. Quantitative Measurements of the Penumbra of XEDS Systems in an AEM. Microscopy and Microanalysis, 22(S3): 278-279.
2umマイクロポア20nm 窒化シリコンメンブレンの2umマイクロポア上に20nmゲルマニウム膜を
蒸着、100umフレーム厚3mm径(TEMホルダーに適合) ウィンドウサイズ: 500 x 500um
均一な、蒸着されたゲルマニウム(Ge)/窒化シリコン(SiN);
•検出器エネルギー軸とエネルギー分解能較正
•検出器ウィンドウの伝送評価
•検出器の立体角測定
•電子光学機器システムのピーク測定
•検体ホルダ半影測定
Geは一般にTEMカラムでは検出されないため、校正サンプルは機器のコンポーネントとその信号ピークと誤認することのない材料を提供します。システムのピークが通常発生する領域[2〜9keVおよび11〜20keV]にはGeのピークがありません。

Ge / SiNx膜のアモルファス構造を確認する領域回折パターンの選択
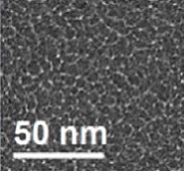
Ge / SiN膜のアモルファス構造を確認する領域回折パターンの選択Geアイランドは、
より高い倍率で目に見えるアイランド間のギャップが<1nm
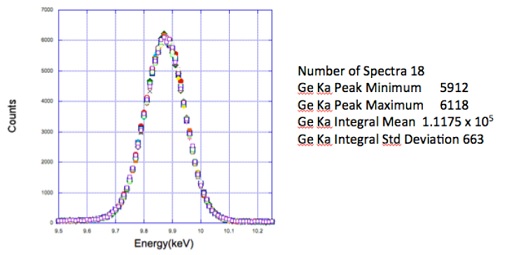
Ge / SiNウィンドウの2つの垂直方向にわたるスペクトルプロファイルの再現性
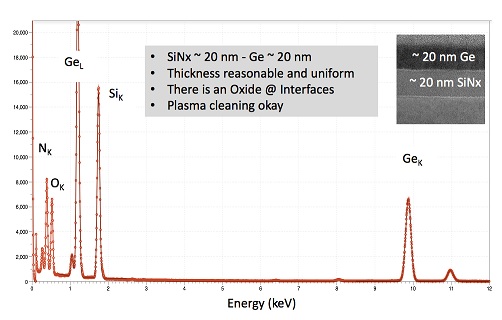
約1nAおよび200kVでの典型的なGe / SiNスペクトルプロファイル
• Zaluzec NJ, DesOrmeaux JP, and Roussie J. A Ge/SiNx Standard for Evaluating the Performance of X-ray Detectors in the SEM, S/TEM and AEM. Microscopy and Microanalysis, 22(S3): 322-323.
• Zaluzec NJ, Wen J, Wang J, and Miller DJ. Quantitative Measurements of the Penumbra of XEDS Systems in an AEM. Microscopy and Microanalysis, 22(S3): 278-279.
2umマイクロポア20nm 窒化シリコンメンブレンの2umマイクロポア上に20nmゲルマニウム膜を
蒸着、100umフレーム厚3mm径(TEMホルダーに適合) ウィンドウサイズ: 500 x 500um
| 型番 | 品名 | 数量 | 価格 |
|---|---|---|---|
| GE20-SN20MP2Q05 | Ge/SiNキャリブレーション | 5/pk | ¥98,000 |

 会社概要
会社概要
